Use of temporary bonding/debonding as part of thin wafer handling processes is rapidly increasing. Users must determine which temporary bonding/debonding method is appropriate for a specific application. Some of the technologies that have been developed are chemical release, thermal slide separation, and ZoneBOND® debonding.

The chemical release process requires very little force to release the thinned device wafers from carriers and is recommended for low-volume, small-format, and compound semiconductor (CS) III-V materials.
The thermal slide debonding process is ideal for small-format applications with throughput requirements of 500-600 wafers (50-150 mm in diameter) per week and with thermal budgets up to 220°C.
The ZoneBOND® process is capable of separating large-format wafer pairs (with diameters of 200 mm or larger) containing large topography and/or perforations. It is also compatible with all wafer sizes, thicknesses, materials, and surface topographies.
Download the white paper to learn more about these three thin wafer handling process methodologies.




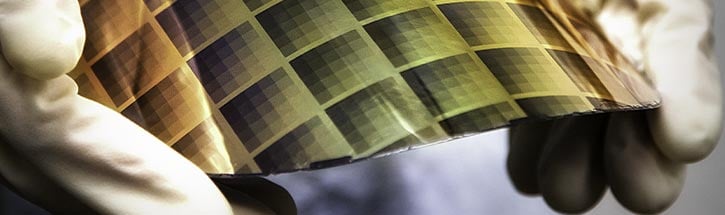
Subscribe to Our Blog